Ellipsometers
Determining thin film properties by change in polarisation of light
Ellipsometry is an optical technique used to measure the properties of thin films. An Ellipsometer will measure the change in polarisation of light reflected off a sample and use this in modelling to determine values such as thickness, refractive index and more.
Ellipsometry is non-destructive and ultra-sensitive to subtle changes in optical properties making it essential for critical applications in semiconductors, photovoltaics, and coatings. Advanced modelling further enhances it’s ability to analyse rough, textured or graded layers.
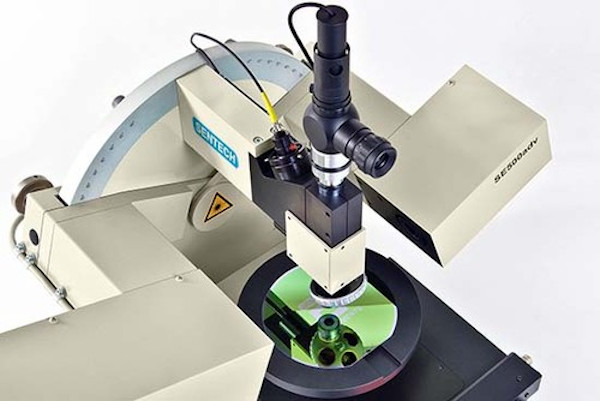
Combined laser ellipsometry and spectroscopic reflectometry

Cost effective spectroscopic ellipsometer

Fully automated, precise and repeatable measurement of film thickness, refractive index, and extinction coefficient

Widest spectral range from 190nm (DUV) to 3,500nm (NIR) for thin and thick films
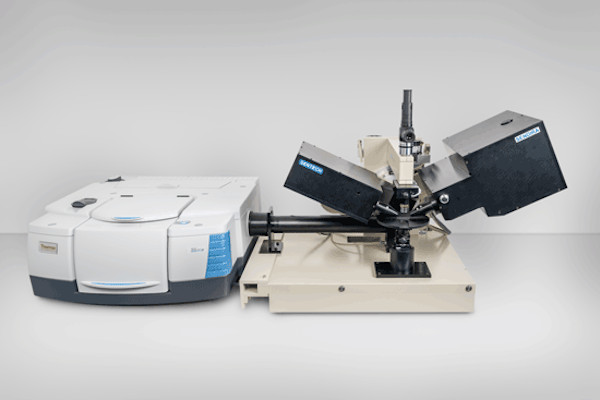
FTIR infrared spectroscopic ellipsometer
Contact us
We’d love to hear from you
We’re here and ready to provide information and answers to your questions
Policy Information
©Mi-Net 2023. All Rights Reserved.
Website by Fifteen.co.uk